
图1 掺杂缓冲层GaN异质外延材料结构
利用Fe元素对GaN缓冲层进行补偿从而提高电阻率的过程中,缓冲层电阻率或者说缓冲层的击穿电压随着掺杂浓度的增加而升高。图2所示为缓冲层击穿电压与掺杂浓度的关系图,可以看出,当掺杂浓度低于4×1018cm-3时,缓冲层击穿电压随着掺杂浓度的增加快速提升,当掺杂浓度进一步提高到8×1018cm-3时,缓冲层击穿电压的增加幅度则渐趋缓慢。当然掺杂浓度提升的同时,由于缓冲层引入的源漏电容Cds也相应增加,Cds的增加使得器件输出端信号通过其泄漏而发生损耗的威胁大为增加,将影响器件的效率,同时Cds的增大也不利于宽带匹配电路的设计,因此从提升器件效率和宽带电路设计需求方面来考虑,掺杂浓度不宜选择过高。另外,高的缓冲层掺杂浓度会使得外延层表面变得粗糙,晶体质量也变差,因此,为了兼顾电阻率和表面质量选择适度的掺杂。在中等掺杂浓度以下,GaN(002) XRD FWHM、表面形貌与非掺杂样品相比几乎没有明显变化,若采用高掺杂则这两项性能均会恶化。考虑到缓冲层掺杂对源漏寄生电容Cds和外延材料表面粗糙度的影响,选取Fe掺杂浓度为4×1018cm-3左右为宜,此时缓冲层击穿电压为200V,相比未掺杂时的不到100V提高了1倍多。
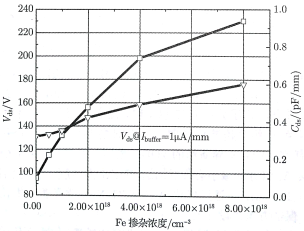
图2 GaN缓冲层的击穿电压及寄生电容与掺杂浓度的关系
按照4×1018cm-3的掺杂浓度所获得的高电阻率GaN缓冲层材料的原子力显微镜(AFM)的测试结果表明其10µm×10µm范围内的表面均方根粗糙度仅为0.28mm,表明Fe掺杂提高外延层击穿电压的同时,GaN表面平整度仍然保持良好。
