对AlGaN的生长工艺,包括压力、温度、源流量等参数的优化,可减小预反应,提高 AlGaN材料的晶体质量和表面的光滑平整度,AlGaN材料10µm×10µm范围表面粗糙度的AFM测试结果表明表面粗糙度可达0.68nm。
除了表面粗糙度,对于AlGaN势垒层应力的控制也至关重要。由于 AlGaN势垒层与GaN缓冲层存在一定的晶格失配,晶格失配大小与Al组分相关,降低Al组分有助于降低势垒层应力,提高器件可靠性。另外,降低Al组分可以提高 AIGaN材料的晶体质量,降低位错及深能级缺陷密度。图1给出了AlGaN材料黄带和带边发光峰强度比(YB/BE)与Al组分的关系(设定Al组分为0.22时YB/BE为1),从图中可以看出,Al组分在0.27以下时,随着Al组分的增加,YB/BE增大不是很明显,但当Al组分超过0.27时,YB/BE急剧增大,这与高Al材料相对较差的晶体质量有关。AlGaN异质结的2DEG密度与势垒层Al组分有非常强烈的依赖性,势垒层A1组分的减小会降低沟道2DEG面密度,增大方阻。因此Al组分需折中选择(如0.26),并通过优化AlGaN/GaN异质界面的生长工艺,提高了2DEG迁移率,保证方阻在设计值范围以内。
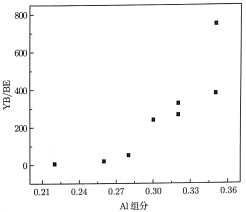
图1 AlGaN材料黄带和带边发光峰强度比与Al组分的关系
高质量 AIGAN/GaN异质结材料生长要求晶体质量高、表面形貌良好,同时异质结的界面清晰、过渡陡峭,沟道电子具有显著的二维特性。图2所示为3in SiC衬底上的GaN HEMT外延材料照片,光学显微镜下观察,材料表面光亮,无明显颗粒。

图2 3in SiC衬底GaN HEMT外延材料照片
图3为SiC衬底 AlGaN/( GaN HEMT材料}的高分辨X射线衍射( HRXRD)2θ扫描测试结果,从左向右四个衍射峰分别为GaN(002)、AlGaN(002)、SiC(004)和AlN(002),其中GaN(002)FWHM很窄(约30〃),表明外延材料具有较高的晶体质量。
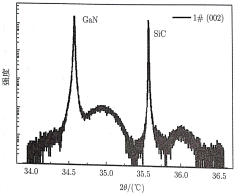
图3 SiC衬底AGaN/AlN/ GaN HEMT结构 HRXRD 2θ扫描曲线
图4为 AlGaN/ GaN HEMT材料电容电压法(C-V法)测试结果,从C-V曲线看出明显的电容平台,且下降沿较为陡峭,表明异质结沟道电子限域特性明显。
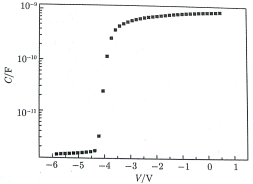
图4 AlGaN/ GAN HEMT材料C-V测试结果
通过调整生长模式和界面应力,研制的3in GaN HEMT外延材料2DEG室温Hall移率达2100cm2/(V`s)以上,不均匀性可控制在2%以内,方块电阻均值在310~320Ω/□范围,不均匀性可控制在3%以内,如图5所示。
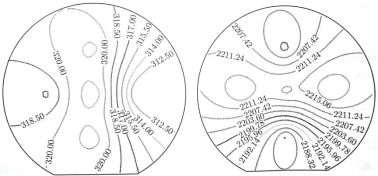
图5 3in SiC衬底GaN外延片室温下方块电阻与2DEG迁移率测试结果
