GAN HEMT材料的生长包括成核层、缓冲层和 AIGAN/GaN异质结等关键步骤。下文是关于成核层技术的内容,在后面的文章也有关于缓冲层和 AIGAN/GaN异质结等技术的讲解。
高温AlN应力控制技术
成核层技术可以说是GaN异质外延生长技术中最关键的一项,该技术的出现才使GaN异质外延材料实现了由非晶向单晶的质变,也才能有现在GaN技术的出现。凭借成核层技术的发明以及GaN材料p型掺杂关键技术的突破,Akasaki、Amano、Nakamura三人分享了2014年度诺贝尔物理学奖。到目前为止,异质外延GaN材料的生长都是基于上述三人开发的经典的两步生长法,即首先在衬底上采用低温生长薄的成核层,然后升高温度生长厚的高温GaN层。成核层的主要作用是给高温GaN层的生长提供必要的成核中心、降低GaN与衬底间的界面自由能以促进反应物原子在衬底上的吸附和GaN薄膜的横向生长。后来也演化出采用高温生长成核层的技术,但其所起的作用并没有本质变化。
在SiC衬底上生长GaN外延层,外延层与衬底之间除了晶格失配之外,热膨胀系数差引起的热失配问题也非常严重,往往导致从生长温度降低到室温的过程中的薄膜开裂现象。在SiC衬底上生长GaN通常采用AlN为成核层,一方面提供成核中心,促进外延生长,另一方面使AlN对GaN层形成压应力作用,以补偿热失配造成的张应力,抑制外延层裂纹的出现。AlN和GaN的晶格常数都比SiC大,它们在SiC上生长都将产生压应力。AlN的热膨胀系数和SiC差不多,而GaN的热膨胀系数比SiC和AIN都要大,因此材料生长后降温过程中,GaN将受到一个来自于AlN成核层的张应力,因此AIN成核层在GaN生长过程中起到非常重要的作用,有必要深入研究AlN的生长技术,实现应力控制,获得高质量无裂纹GaN外延材料。在SiC基GaN的生长中,业界普遍采用较低的温度生长AIN成核层,这在工艺稳定性和重复性上具有一定优势,但是由于温度较低,生长得到的成核层缺陷密度较高。为了获得高的晶体质量,并实现应力平衡,可采用高温AIN应力控制技术,生长出高质量GaN材料。
首先,将AlN成核层的生长温度由原来的920℃提高到1020℃,以改善GaN与SiC衬底之间的浸润性,促使后续GaN以二维层状生长模式进行生长。为了防止降温过程中GaN层受到的张应力超过临界值发生开裂,还通过调节AlN成核层的厚度来层的厚度来实现各层之间的应力平衡。由于各台MOCVD设备性能参数之间的差异,通常无法借鉴他人的生长工艺条件,需要有针对性地进行开发。
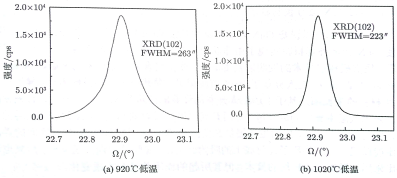
图1 不同温度下AlN成核层上GaN层(102)面XRD测试结果
为此,生长过程中根据实际情况对高温AlN成核层厚度、气流、V/Ⅲ比等工艺参数综合调整,提升了成核层和其上GaN缓冲层的质量。图1为920℃和1020℃AlN成核层上GaN缓冲层的XRD测试结果的比较,采用高温成核层工艺后,GaN缓冲层(102)面摇摆曲线半高宽(FWHM)为220’’左右,相比采用920℃AlN成核层的260’’FWHM有明显的改善,表明GaN缓冲层缺陷密度降低,外延层晶体质量得到了提升。
