(1)热电子俘获效应
半导体材料中的电子可以吸收一定的能量而被激发,处于激发状态的电子称为热电子。当器件工作在高电场情况下时,电子被电场加速得到足够的能量而形成热电子,这些热电子有可能被器件中的表面态、界面陷阱和存在的固有陷阱所俘获。对于AlGaN/GaN HEMT器件来说,热电子可能被AlGaN势垒层中的陷阱或者AlGaN表面态的陷阱所俘获,这些被俘获的电子聚集在栅漏之间的有源区或者在AlGaN势垒层表面栅漏之间靠近栅一侧聚集形成“虚栅”,导致器件导通电阻增大,沟道二维电子气密度降低,引起漏电流和跨导下降。在开态电应力情况下,沟道载流子在电场作用下获得足够的能量从沟道逸出成为热电子的主要来源。而在关态电应力境况下,栅漏之间靠近栅边缘一侧存在一个强场峰,栅极电子在强电场的作用下隧穿到AlGaN势垒层表面,从栅级隧穿的电子是热电子的主要来源。AlGaN/GaN HEMT器件中热电子的产生和被陷阱俘获的过程如图1所示。
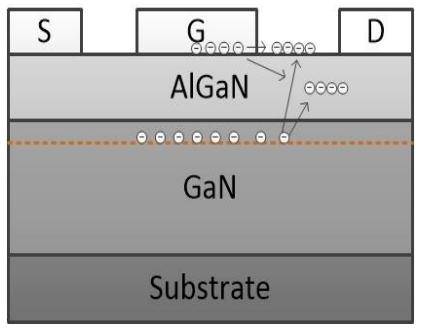
图1 热电子俘获效应示意图
(2)热电子产生陷阱效应
热电子产生陷阱效应是最早被普遍认可的退化机制之一。器件在电应力作用前后特性的对比表明应力后器件中出现大量的陷阱,特别是在开态电应力下器件的陷阱密度显著增加,而关态电应力下并未发现明显的变化。陷阱的产生归结于开态应力下电场对沟道中载流子的加速作用。热电子产生陷阱效应认为器件处于开态、关态或射频工作应力下,沟道中的电子被强电场加速成为高能热电子,热电子溢出沟道很有可能隧穿到钝化层和沟道上方的AlGaN势垒层,在钝化层和AlGaN势垒层中产生陷阱,这些陷阱导致AlGaN势垒层表面耗尽,漏串联电阻增加,栅漏之间的电场减小。热电子产生陷阱过程如图2所示。研究表明,热电子在器件中产生的陷阱似乎是永久的,器件静置几个月时间后并没有发现退化特性的恢复。
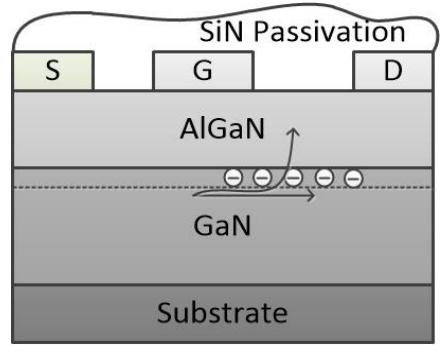
图2 热电子产生陷阱效应示意图
(3)逆压电极化效应模型
AlGaN/GaN异质结中存在较强的张应变和压应变。逆压电极化效应认为,强电场应力下AlGaN势垒层中的缺陷是通过AlGaN势垒层的应变松弛而产生的与热电子诱导陷阱的形成机制不同。当对器件施加一个强电场,逆压电效应导致AlGaN势垒层膨胀,张应变增强,如果总的应变量超过一个关键值,应变可以通过晶格弛豫得到释放,形成缺陷,例如位错缺陷。这一机制最关键的信号就是栅泄漏电流几个数量级的突然增加,并且泄漏电流的增加是不可逆的。这种退化机制是电压驱动的,以临界电压为特征,当应力电压小于临界电压时,退化不会发生。图3所示逆压电极化效应在AlGaN势垒层中产生缺陷,形成栅泄漏电流通道。
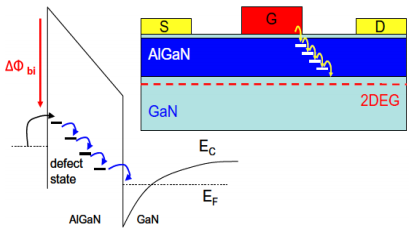
图3 逆压电极化效应示意图
目前有关逆压电极化效应产生的缺陷起受主作用还是施主作用还存在分歧,没有定论。图4所示晶体中一个位错界面,在位错所在位置,原子E与周围三个原子形成共价键,还有一个不成对的电子形成不饱和的共价键,这时原子E为电中性状态。当这一不饱和键俘获一个电子后,原子E多了一个电子而成为负电中心,起了受主作用,当原子E失去这一不成对的共价键电子后而成为正电中心,起了施主的作用。
高能载流子、高温、栅注入的局部电流都能加速逆压电极化效应,从而缩短器件寿命,可以采用合适的器件结构,例如:场板结构、栅绝缘层、或者凹槽栅结构,来抑制这些效应。

图4 晶体中一个位错截面示意图
(4)金属接触退化机制
对器件施加电应力,大的应力电流使得器件输出功率增大,有可能造成器件温度迅速升高,对器件栅肖特基接触和源漏欧姆接触造成损伤。研究发现,当器件工作在栅空置情况下,源漏应力电流为1.65A时,对器件造成永久性损伤,分析认为是器件源漏欧姆接触烧坏;当器件工作在栅接地的偏置下,源漏应力电流为0.45A时,使得器件永久性损伤,分析认为是栅肖特基结失效引起的。目前的金属化技术已经非常成熟,可以保证室温下器件的金属接触不会老化,器件材料本身固有的缺陷是导致高温情况下器件退化的主要原因。栅退火工艺可以改善栅金属半导体界面质量,提高器件可靠性,使得退化量明显减小。
