
图1 关态栅阶梯应力示意图
图2所示器件阈值电压Vth,最大跨导Gmmax,最大漏电流IDmax,栅泄漏电流IG随栅漏间应力电压VDGstress变化情况。从图中可以看出器件跨导最大值Gmmax、最大漏电流IDmax随着应力电压的增大而减小,而器件阈值电压Vth随着应力电压的增大正向漂移,其中跨导最大值Gmmax下降了16%,最大漏电流IDmax下降了百分之20%,阈值电压Vth增大了18%,这与图3(a)所示漏电压VD=1V情况下器件施加关态栅阶梯应力前后转移特性变化相一致。而栅泄漏电流IG的变化情况最为特别,在VDstress=0V关态栅阶梯应力下,器件的栅源和栅漏同时存在强电场,栅泄漏电流包括栅源电流和栅漏电流两部分。图3(b)所示器件施加关态栅阶梯应力前后栅泄漏电流特性,可以看出应力结束后栅泄漏电流增大约一个数量级,这与图2中栅泄漏电流随应力电压的增大而减小的情况不同。这说明在VDstress=0V关态栅阶梯应力下,器件中同时存在热电子驱动的电子俘获效应和高电压驱动的逆压电极化效应,而且陷阱对电子的俘获效应占主导地位。
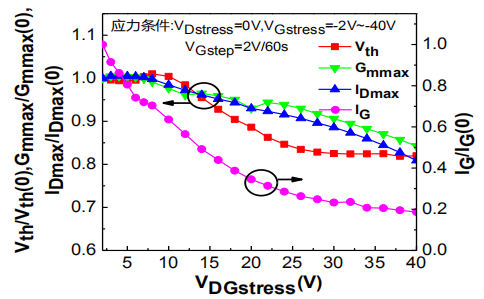
图2 关态栅阶梯应力下器件阈值电压Vth、最大跨导Gmmax、最大漏电流IDmax、栅泄漏电流IG变化情况
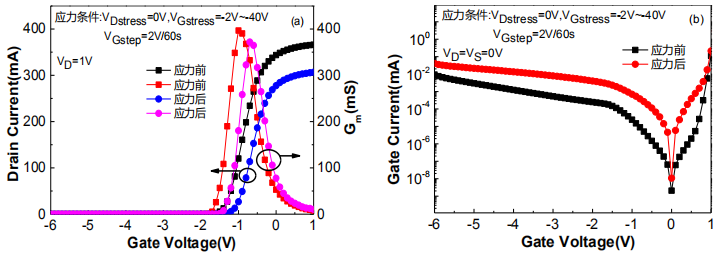
图3 关态栅阶梯应力后器件(a)转移特性和(b)栅泄漏电流特性的变化情况
在关态情况下,栅源和栅漏两端的应力电场使得栅极电子隧穿到AlGaN势垒层中,被AlGaN势垒层中的陷阱或表面态所俘获,陷阱填充后,栅泄漏电流路径受阻,导致栅泄漏电流减小,而静电效应导致一部分沟道中的二维电子气耗尽,使得阈值电压Vth向正向漂移,跨导最大值Gmmax和最大漏电流IDmax减小。强场应力下,逆压电极化效应使得AlGaN势垒层中产生缺陷,形成泄漏电流路径,导致栅电流增大。因此,在应力过程中,陷阱对电子的俘获机制占主导作用,使得栅泄漏电流随着应力电压的增大而减小,而应力结束后,陷阱开始释放俘获的电子,逆压电效应形成的漏电通道使得栅泄漏电流增加。
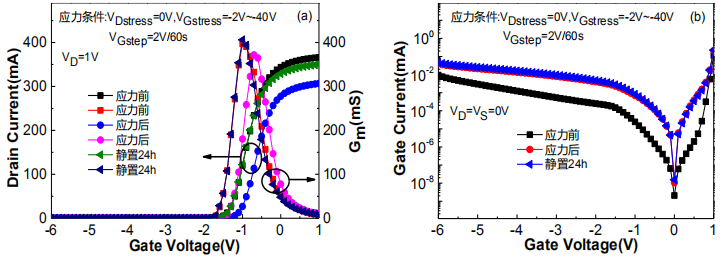
图4 关态栅阶梯应力后器件静置24小时(a)转移特性和(b)栅泄漏电流特性的变化情况
对器件施加关态栅阶梯应力后,器件静置24小时,测量其转移特性和栅泄漏电流特性,如图4所示。可以看出静置24小时后器件转移特性基本恢复到应力前的水平,而栅泄漏电流依然保持增大的状态,这进一步证明了,应力结束后,AlGaN势垒层中的陷阱释放了俘获的电子,而且逆压电极化效应对栅肖特基结造成了不可恢复的损伤,形成了一条永久的栅泄漏路径。
