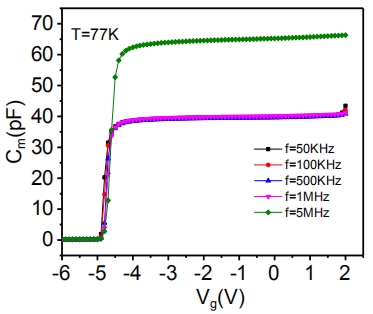
图4 T=77K变频C-V曲线
图5左、右两图中分别给出了T=77K温度条件下测试所得的不同偏压条件下实测并联电容和电导随测试频率的变化曲线。
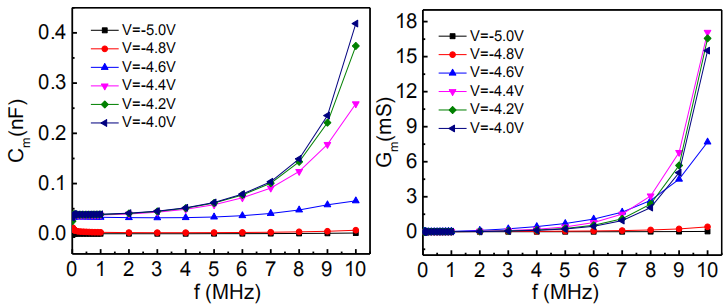
图5 T=77K变频电容(左)和变频电导(右)曲线
根据式(5)给出的关系,对77K、90K、100K、120K和200K等五个温度点下测试得到的变频电容和电导曲线进行处理,得到各个温度下Gp/ω随ω变化的分布图。结果显示,在栅极偏压Vg=-5.0V时,Gp/ω随ω的变化呈无序化杂散分布,这主要是因为在这一偏压条件下,GaN HEMT器件仍然处于深耗尽状态,电容信号的延迟现象不明显。图6中给出了T=77K通过多项式拟合所得到的的Gp/ω~ω曲线。需要说明的是,由于Vg=-4.8V时得到的拟合曲线与其他偏置点下的结果相比数量级较小,在同一幅图中很难清楚地反映其变化规律,因此这里采用在图右上角嵌入图片的形式来对Vg=-4.8V时的拟合结果进行显示。
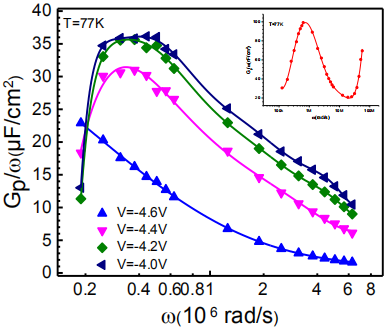
图6 T=77K Gp/ω~ω曲线
从图6所给出的结果中可以看到,当T=77K时,除栅压Vg=-4.6V外,其余四个电压偏置条件下的Gp/ω~ω拟合曲线在所测频率范围内都存在极大值点。为了进一步验证Vg=-4.6V下曲线极大值点是否与温度有关,紧接着对T=90K、100K、120K和200K下得到的测试结果采用与上述相同的方法进行数据处理和曲线拟合,得到的结果在图7中以类似的方法给出。从图7中的结果可以看到,当温度T≥100K时,Vg=-4.6V偏置条件下的Gp/ω~ω拟合曲线在所测频率范围内也出现了极大值。
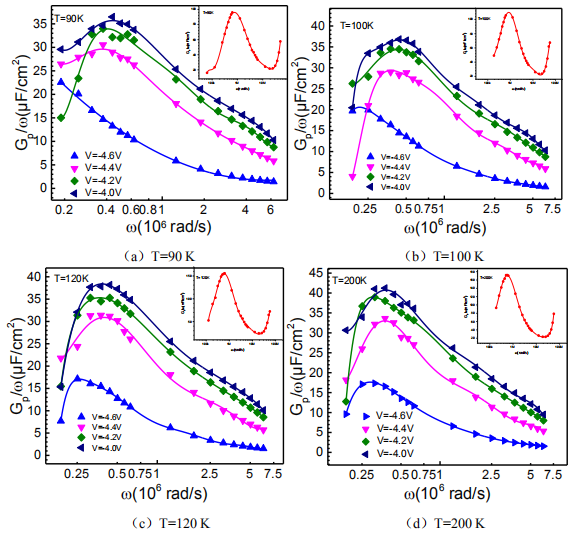
图7 不同温度下Gp/ω~ω曲线
从电导法的分析可知,根据式(5)中的关系拟合所得到的Gp/ω~ω曲线在ω≈2/τit处取得最大值,并且在曲线最大值点得出的陷阱密度Dit=2.5Gp/qω。因此,我们通过对图6和图7中所示各曲线的最大值进行提取,就可以计算出不同温度下AlGaN/GaN异质结界面处的陷阱密度和发射时常数。图8和图9中分别给出了不同温度下陷阱发射时常数和界面态密度随外加偏压的变化曲线。
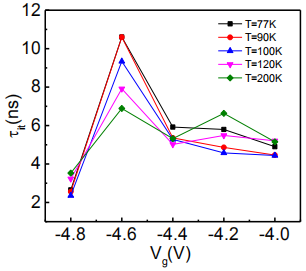
图8 不同温度下陷阱发射时常数变化曲线
观察图8中陷阱发射时常数随偏压的变化曲线可以看到,Vg=-4.6V时得到的时常数明显偏大,我们猜测,这主要存在两方面的原因,一个是,当栅极偏压处于器件阈值电压临界点上时,材料界面处的能带结构将发生明显变化,使得原本较深能级的陷阱态可以发射/俘获电子,从而引起常数增大;另一方面,温度的降低对该偏置点下的深陷阱能级的发射/俘获具有辅助作用。
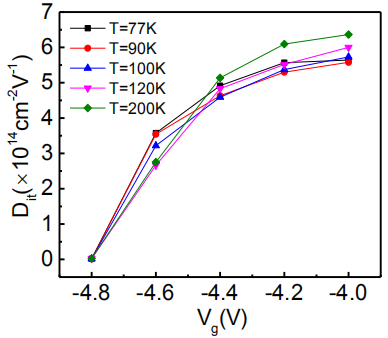
图9 不同温度界面态面密度变化曲线
从图9中可以看到,当栅极偏压从GaN缓冲层深耗尽区向2DEG积累区变化,异质结界面处的陷阱密度逐渐增大,并且增大的速度在2DEG积累区明显变小。从图中还可以看到,温度在77K~200K范围内变化时,界面陷阱密度的变化并不十分明显,即可以近似认为,低温范围内,异质结界面陷阱电荷对温度变化不敏感。
其他人还看了
GaN异质结界面态特性分析(一)
