自2008年AlGaN/GaN MIS-HFET成为研究热点以来,因无法像Si材料一样轻易的获得本征氧化层,GaN基MIS器件的栅介质材料就被广泛关注。包括SiNx、SiO2、Al2O3、AlN/Al2O3、LaLuO3、LaAlO3/SiO2、HfO2、TiO2、Si2O3/Al2O3等材料。对高k材料的选择越来越多。
在现有的实验条件下,原子层淀积(Atomic Layer Deposition,ALD)Al2O3成为最优的一种栅介质选择。原子层淀积是通过控制气体反应物表面反应并使反应生成物附着在晶圆表面的单分子层淀积技术。原子层淀积在厚度上具有良好的均匀性,易实现100%台阶覆盖,附着性良好,对衬底材料无损伤,同时具有低应力、低缺陷密度、低成本、高效率等优点。使用Al(CH3)3和去离子水作为Al源前驱体和O源前驱体,氮气作为载气进行Al2O3介质层淀积。Al2O3相对介电常数约为9~12,是一种高k介质,禁带宽度约为8.9eV,并具有5~10MV/cm的高击穿电场,1000℃下仍能保持无定型的热稳定性。从淀积方法来看,原子层淀积的Al2O3质量远胜于电子束蒸发或磁控溅射所获得的Al2O3,目前已成为淀积Al2O3介质的首选技术。
2011年Mizue C等人对AlGaN/GaN异质结表面原子层淀积生长Al2O3做了一系列卓有成效的工作,并对Al2O3/AlGaN界面特性进行了定性分析。AlGaN/GaN异质结上淀积不同厚度Al2O3的C-V特性曲线如图1(a)所示,可以看出随着Al2O3厚度增加,饱和电容值增大、阈值电压降低,根据偏压0V时的电容值反推Al2O3的相对介电常数约为9.5~9.7,与相关报道一致,证明C-V测试结果可靠。图1(a)中陡峭的C-V曲线证明Al2O3与AlGaN/GaN之间良好的界面特性。Al2O3对AlGaN/GaN沟道区2-DEG浓度的影响如图1(b)所示。可以看出,当Al2O3厚度为15nm和20nm时,2-DEG浓度有小幅下降,Al2O3厚度为5nm和10nm时,2-DEG浓度基本不变,这表明原子层淀积生长的Al2O3与AlGaN/GaN异质结存在的应力较小。
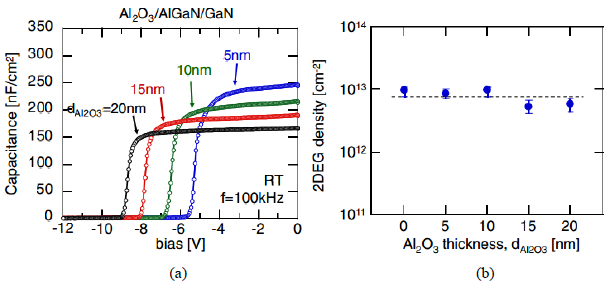
图1 (a)Al2O3/AlGaN/GaN结构C-V特性;(b)沟道2-DEG浓度
栅极肖特基金属淀积
AlGaN/GaN HFET器件栅电极通常由肖特基金属制作。肖特基接触具有整流特性,随着外加电压的变化,肖特基接触的耗尽区也发生变化,从而控制AlGaN/GaN HFET器件的开关。栅肖特基电流可以表示为:

从(1)式可看出,当栅极电压一定时,提高肖特基金属势垒高度可以有效降低栅极泄漏电流。所以高功函数金属成为肖特基金属的主要选择。考虑到实际工艺,所选肖特基金属在半导体表面需要有较好的粘附性,以防止金属在后续工艺中脱落使得器件无法正常工作。除此之外,栅极肖特基金属需具有较好的机械稳定性和热稳定性。目前栅金属淀积工艺中主要选择为电子束蒸发或磁控溅射Ni/Au组合,Ni为栅极肖特基金属,Au用以降低栅极电阻并防止Ni被氧化。本实验中Ni/Au厚度为40/450nm。
H.Kim等人的研究表明肖特基栅极金属与AlGaN接触界面的界面态会导致明显的栅极漏电。较大的栅极漏电会严重影响器件的可靠性。Takuma NANJO等人针对这个问题,选用Ni(3nm)/Pt(30nm)/Au(300nm)作为栅极金属,金属淀积后在600℃下进行5min热退火后,可以观测到器件反向栅极泄漏电流显著下降,该课题组对这一现象的原因进行合理的推理:第一,Pt穿过较薄的Ni层扩散至AlGaN表面,从而提高了金/半接触的势垒高度(不直接选用Pt做栅极金属是因为Pt粘附性较差);第二,在高温退火过程中,Ni与AlGaN层发生了反应减少了表面陷阱。
