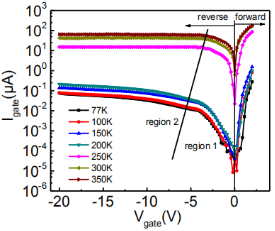
图1 GaN HEMT栅漏电变温曲线
1. AlGaN/GaN HEMT器件正向栅电流研究
基于GaN 器件的热电子发射理论,对图1中测试得到的GaN HEMT器件栅漏电曲线在正偏压范围内的结果进行处理,得到各个温度点下栅极电流lnJ随外加偏压Va的变化曲线。根据上一篇GaN器件的主要栅漏电机制的介绍,需要对曲线上线性度较高的区域进行线性拟合,而后提取拟合直线的斜率和截距,再分别利用(3)式和(4)式中给出的关系来计算得到不同温度下GaN HEMT器件肖特基栅的理想因子和有效势垒高度,图2(a)和2(b)分别给出了对应结果。观察图2(a)可以看到,当温度处于250K~350K的范围内时,理想因子比较接近理想值,即可以近似认为在该温度范围内形成GaN HEMT器件栅电流的主导机制是热电子发射。而当温度低于200K后,得到的理想因子值远远偏离了理想值1,这就表明,低温下形成GaN HEMT器件栅漏电的主导机制不再是热电子发射。根据下文中的分析可知,低温下AlGaN/GaN肖特基栅正向电流主要是由隧穿机制引起的。

图2 (a)不同温度下的理想因子 (b)有效势垒高度AlGaN/GaN HEMT器件
反向栅漏电研究考虑到AlGaN势垒层材料的禁带宽度较大,电子直接跃过整个势垒比较困难,因此在本文对AlGaN/GaN HEMT器件反向栅漏电进行分析的过程中我们将直接隧穿对栅漏电的影响忽略不计,主要考虑上一篇GaN器件的主要栅漏电机制中所讲到的F-N隧穿机制和FP发射机制的作用。从理论知识可以看到,对于F-N隧穿和FP发射机制而言,在对这两类机制产生的栅极漏电进行分析的时候,我们首先需要知道势垒层中的电场分布信息。而有关理论研究表明,势垒层中的等效电场强度Eb可以通过下式进行计算:

上式中,σp(-)表示负电性的表面极化固定电荷,通常可以取值为1.44×1013cm-2,ns(V)代表异质结界面处的二维电子气面密度,可以通过相应器件的C-V曲线进行积分得到,ɛs是AlGaN势垒层的相对介电常数。
图3(a)给出了T=300K下ns(V)随外加栅压Vgate的变化关系,由于前文中我们通过分析计算得到2DEG面密度随温度的变化不明显,所以此处就将300K下求得的ns(V)结果代入上篇文章中式(10)中来计算不同栅压下的势垒层纵向电场Eb,计算所得结果如图3(b)所示。
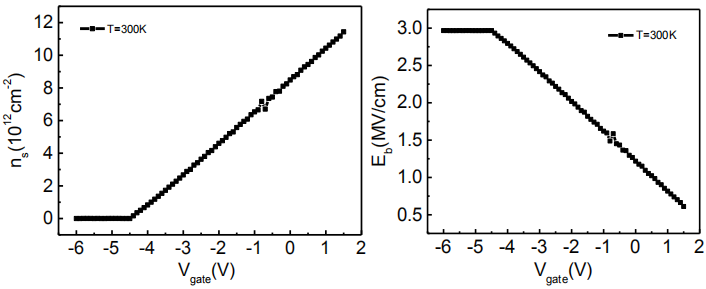
图3(a)二维电子气面密度随栅压变化曲线 (b)势垒层电场随栅压变化曲线
利用图3(b)中得到的电场强度,对测试得到的反偏栅漏电结果进行处理,用以分析不同温度范围内形成栅漏电的主导机制。同时,在拟合过程中需要特别注意,对于F-N隧穿机制所产生的栅漏电,除了要保证lnb(J/E2b)随1/Eb近似呈线性变化,另外根据上篇文章中式(6)和(7)中给出的各个参数的实际物理意义可以判断,参数B的取值应该大于0,亦即拟合所得直线的斜率应该为负值。综合考虑以上各因素,对图1所示负偏压区域的栅漏电进行分析,最终所得ln(J/E2b)和1/Eb之间的拟合结果如图4所示。其中与横坐标所对应的栅极外加偏压范围是-3.28V~-1.52V。从图中可以看到,在T=77K、100K、150K和200K这四个温度点下ln(J/E2b)与1/Eb呈良好的线性关系。这就说明当温度低于200K时,形成栅漏电的主要机制是F-N隧穿。
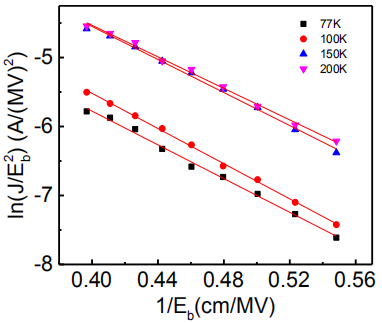
图4 77K~200K F-N隧穿机制拟合曲线
对于温度大于200K的情况,拟合结果表明ln(J/E2b)随1/Eb的变化不满足线性关系,即温度较高,F-N隧穿不再是引起栅漏电的主导机制。此时,我们考虑FP发射机制的作用,对
 的之间的变化曲线进行拟合。同样地,从上篇文章中式(9)可以看到,拟合得到的直线斜率m(T)应该大于0,根据这一条件,得到了图5所示的结果,所对应栅偏压范围为-2.84V~1.3V。从拟合结果可以看出,在T=250K、300K和350K三个温度点下,
的之间的变化曲线进行拟合。同样地,从上篇文章中式(9)可以看到,拟合得到的直线斜率m(T)应该大于0,根据这一条件,得到了图5所示的结果,所对应栅偏压范围为-2.84V~1.3V。从拟合结果可以看出,在T=250K、300K和350K三个温度点下, 呈线性变化关系,另外图6(a)和6(b)中分别给出了拟合直线的斜率m(T)和截距b(T)随1000/T的变化关系,可以看到,两者都呈现出较好的线性度,从而进一步验证了在这一温度范围内,GaN HEMT器件的栅漏电满足FP发射机制,即在较高温度下引起AlGaN/GaN HEMT器件栅漏电的主要机制是FP发射。
呈线性变化关系,另外图6(a)和6(b)中分别给出了拟合直线的斜率m(T)和截距b(T)随1000/T的变化关系,可以看到,两者都呈现出较好的线性度,从而进一步验证了在这一温度范围内,GaN HEMT器件的栅漏电满足FP发射机制,即在较高温度下引起AlGaN/GaN HEMT器件栅漏电的主要机制是FP发射。
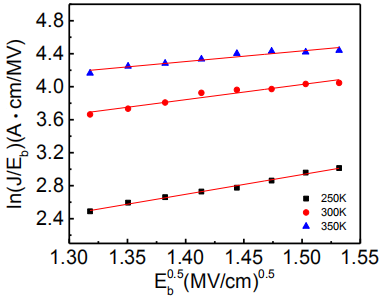
图5 250K~350KFP发射机制拟合曲线
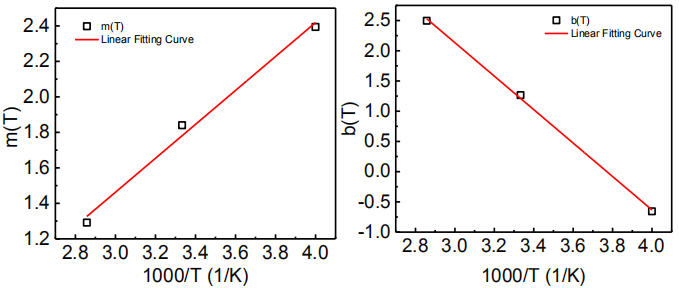
图6 (a)FP拟合斜率m(T)和1000/T关系 (b)FP拟合截距b(T)和1000/T关系
