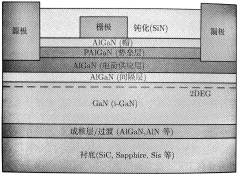
图1 典型GaN HEMT器件结构示意图
1)衬底
衬底是器件外延的载体,对射频性能的影响较大。它的选择需综合考虑成本、与外延层的晶格匹配度、热导率和大尺寸晶圆获取的难易程度等因素。常用的几种介质基板材料(SiC,蓝宝石,Si,金刚石等)表1作了详细对比阐述,Si和SiC材料是目前微波毫米波频段 GaN HEMT应用最广泛的衬底,正在开发金刚石基GaN HEMT。
表1 五种半导体基板材料特性典型比较

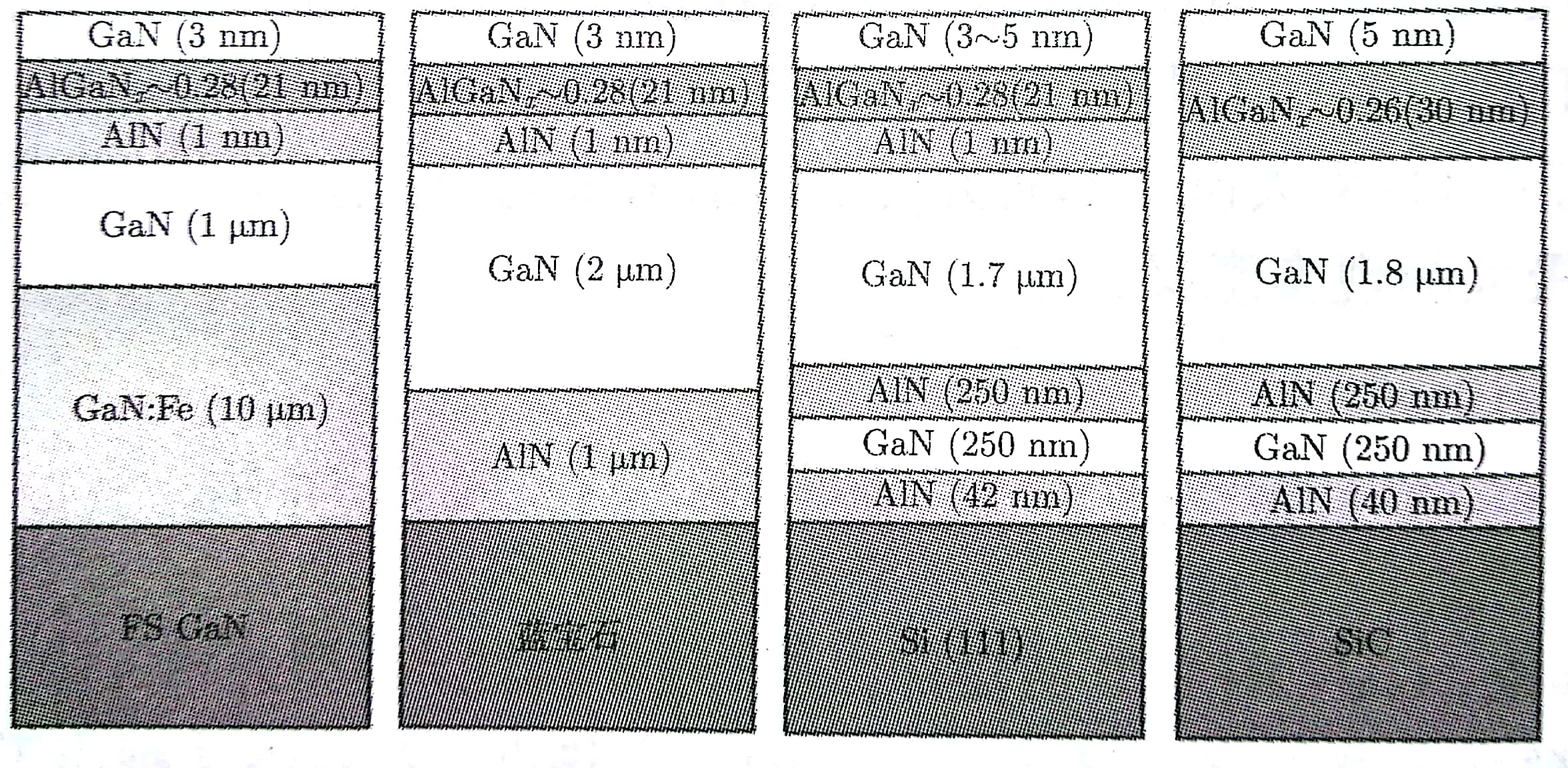
图2 不同介质基板GaN HEMT典型器件结构示意图
2)成核过渡层( transition/ nucleation)
由于介质基板与GaN缓冲层存在晶格不匹配问题(GaN基板除外),如SiC与GaN间晶格失配率为3.5%,需要引入一定厚度(纳米级)的过渡层(AlGaN或AIN)来减小该失配引起的界面张力。该过渡层对减小界面失配、缺陷或陷阱效应引起的电流崩塌,降低静态电流泄漏及射频传导和改善射频性能有重要作用。
3)GaN缓冲层( buffer)
非故意掺杂(UID)的半绝缘缓冲层具有高阻性,厚度通常在微米级,用于形成2DEG,并降低背景载流子浓度以减小缓冲层陷阱效应引起的漏极电流崩塌。
4)间隔层( pacer)及电荷供应层
间隔层用于分隔掺杂的 AIGAN电荷供应层与GaN缓冲层异质结,减小掺杂的 AIGAN层离子散射对沟道中2DEG迁移率和浓度的影响。厚度越大对降低散射的作用越明显,但同时也会限制电子到达沟道中,降低了电子浓度。对电荷供应层AlGaN掺杂一定密度Si,能提高2DEG电子浓度和改善直流特性,但与未掺杂的器件相比,其射频特性通常更差一些,主要是由于掺杂引起的散射降低了2DEG的电子饱和速率。
5)势垒层( barrier)
势垒层为栅极肖特基接触提供一定的势垒高度。由于表面陷阱的影响,较薄的势垒层电场强度更大,电流崩塌会更严重,饱和输出功率更低;但较厚的势垒层会增大寄生效应,降低小信号增益特性。所以需要折中考虑势垒层厚度对器件特性的影响。
6)帽层cap)及钝化层( passivation)
帽层和钝化层对于减小漏极电流崩塌,维持极化特性产生的2DEG有重要作用。同时也能减小栅极泄漏电流,增强源、漏极欧姆接触和击穿电压。二氧化硅和氮化硅往往作为钝化处理材料。钝化处理后, GaN HEMT的沟道电子浓度约有20%的提升。
7)电极接入区
栅极肖特基接触通常采用镍/金(Ni/Au)或铂/金(Pt/Au)合金材料,它们具有高功函数,可以抑制栅极泄漏电流。常用凹栅或T型栅等结构减小寄生效应,改进器件垂直方向上的纵横比,降低短沟道效应,提高射频特性。源、漏极欧姆接触通常采用钛/铝(Ti/Al)或钛/铝/钛/金(Ti/Al/Ti/Au)等多层合金,n型重掺杂,以减小欧姆接触电阻。为了改善击穿特性,栅-漏间距往往比栅-源间距更大。
